行业动态
数据中心流量的爆炸式增长推动了对更高带宽、更高能源效率光互连的需求。硅基光电子技术与电子-光子共封装是前景广阔的解决方案。本文综述博通公司的最新工作,展示了高密度组装、远端激光器一体化和光连接器等光电共封装的关键技术。提出一种“半封装”的光交换原型系统,与传统光模块相比可实现匹配的带宽密度提升一倍的功率节约。文章还讨论了规模化生产下进一步提升密度、功效率和降低成本的前景。
云计算、AI、5G、物联网等业务的爆炸式增长使数据中心网络带宽面临严重的瓶颈。铜质电接口在密度、散热和传输距离方面正碰到基本物理极限。虽然可插拔光模块暂时缓解了这些问题,但是在 400G 以上速率扩展时会面临密度、功效率和成本的挑战。硅基光电子与先进电子-光子共封装(简称共封装)可实现数量级的飞跃,大幅提高带宽密度、能源效率和成本效益。这是通过应用大批量 CMOS 工艺实现光子与交换/计算 ASIC 的高密度集成来实现的。异质集成的高速光电子系统可实现更紧密的结合,解锁性能、功效率和可扩展性的优势。 本文综述博通的最新工作,展示实现高密度数据中心光交换共封装所需的关键技术。提出一种“半封装”光交换原型系统,相比传统光模块可实现一半的功率[1]。文章还讨论了共封装在密度、功效率、可靠性和成本方面的进一步提升前景。
共封装的关键技术之一是实现超高密度电-光 I/O 引脚配准。博通的 SCIP(Silicon Chiplet Photonics Package)技术利用 TSV 和高密度键合,实现硅基光电子chip 和 ASIC chip 在 130um 引脚距下对准(图 1)[1]。高密度短距(150 um)线路实现了每比特能量效率低于 1pJ,比现有技术提高 10 倍。博通实现高密度三维堆叠芯片级封装,采用晶圆键合的加工过的 ASIC 和光子晶圆 (图 2)[1]。实现稳定的对准和键合以及晶圆薄化(75 um)、TSV 开槽均匀性和隐形切割等技术对高密度集成至关重要。随后基板上顺序共封装键合的芯片/光学引擎和 ASIC 利用焊膏回流和精确的底部充填来实现。
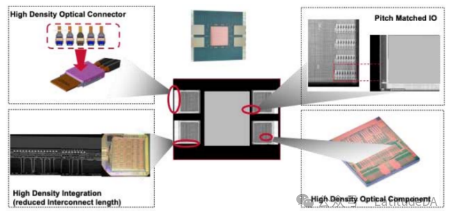
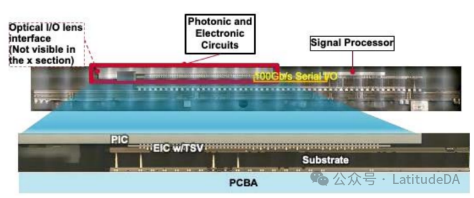
由于硅基光电子无法一体化集成激光器,因此需要使用远端激光模块(RLM)提供光源[1]。博通设计实现热插拔 RLM,遵循 QSFP-DD 标准,单通道提供高达 21dBm 的光功率并实现安全锁定(图 3)[1]。RLM 实现与光引擎的连接器盲配对,方便维护更换。
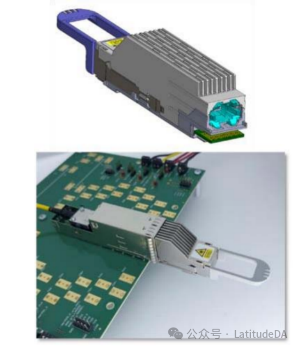
博通还研发了适用于回流焊接的中端密度(127 um 引脚距)热插拔光连接器,使光电共封装系统可以实现插座安装或焊接安装的灵活性(图 4)[1]。该定制连接器应用成熟的光纤阵列工艺确保可靠性,并支持现场更换。博通已在 14.43mm 的紧凑光子芯片边缘演示了低损耗、可重复配对高达 72 对光纤的光连接器。这种“插拔式”共封装光系统简化了组装和升级。

图 5 展示博通“半封装”光交换原型系统[1]。4 个光引擎每个包含 32 路 100Gbps 与 ASIC 芯片共封装。RLM 提供光源,每个包含 8 个激光器的 RLM 支持每个光引擎的 32 个发送通道。芯片与光引擎之间的电插入损耗仅 2-3 dB,比可插拔模块低 5 倍(图 6、7),从而将接口功耗降低一半。共封装光系统符合 IEEE 标准,接收机灵敏度余量充足(图 8、9)。
该半封装光原型系统证明共封装光学可交付与可插拔模块相当的带宽,功耗仅为其一半。尽管还需要进一步工程化实现全面商用,但密度、效率和性能的重大提升源自紧密的共封装。将这些技术推广至先进 CMOS 工艺和新一代光子技术,将可实现更高密度的带宽扩展。
可靠性、热设计、制造能力、组装成本及软件集成等技术挑战仍待解决。但是,考虑到数据中心业务量的陡峭指数增长,规模化应用带来的功率和成本节约非常可观。共封装技术的推广类似 2.5D 硅基板载板用于 ASIC 集成的快速发展。集成激光器、光背板和先进 CMOS 光互连等前沿技术进展非常乐观。
未来十年,共封装光技术将应用于主流以突破高性能计算和网络中的铜质瓶颈。博通等公司在高密度光子集成功和先进三维封装等关键技术的重要进展奠定了实现这一颠覆性变革的基础。
金年会网页版在线登录